Pracovníci | Publikácie | Späť

Rast tenkých vrstiev oxidov technológiou nanášania po atomárnych vrstvách (ALD)
Rast po atomárnych vrstvách (atomic layer deposition, ALD) je chemická metóda prípravy
tenkých vrstiev, predovšetkým oxidov. Metóda je založená na opakovaní sekvencie
technologických krokoch, pri ktorých narastie sub-atomárna tenká vrstva oxidu.
Technologický proces sa vyznačuje nízkou teplotou prípravy, vysokou opakovateľnosťou a
rovnomerným rastom na veľkých podložkách, ako aj na zložitých 3D povrchoch. Nanášaním
po atomárnych vrstvách vieme na Elektrotechnickom ústave SAV pripraviť tenké vrstvy
Al2O3, TiO2, HfO2, ZrO2.
Samotný rast technológiou ALD sa dá rozdeliť do štyroch krokov:
1. prísun východzích chemických látok (prekurzora), adsorpcia monomolekulovej vrstvy
na povrchu podložky,
2. premývanie reakčného priestoru inertným plynom, odstránenie prebytočných molekúl
prekurzora,
3. prísun reakčného plynu, ktorý rozloží východzie látky, usadené na povrchu podložky,
tvorba jednej atomárnej vrstvy filmu,
4. premývanie reakčného priestoru inertným plynom, odstránenie vedľajších produktov
reakcie.
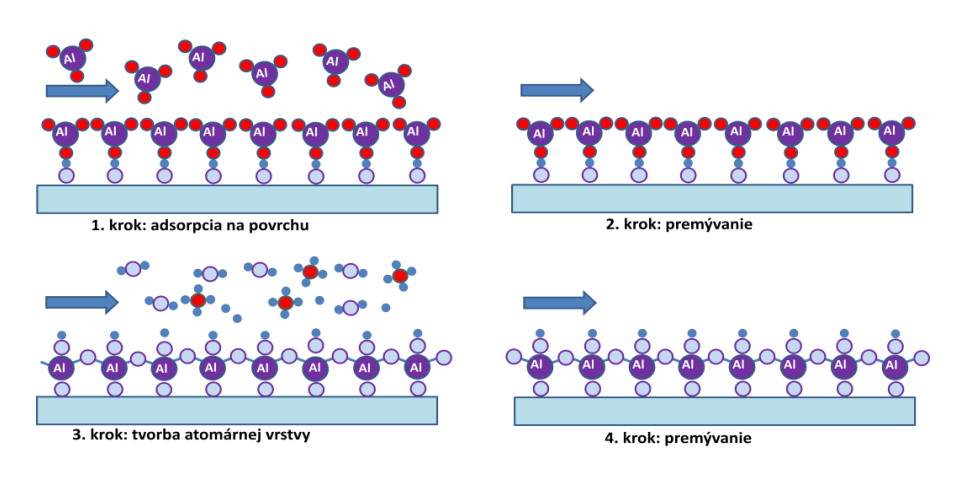
Obrázok: Jednotlivé kroky cyklu nanášania po atomárnych vrstvách pre rast Al2O3.
Dnes sa ALD používa v polovodičovom priemysle pri príprave hradiel CMOS tranzistorov a
mikrokondenzátorov DRAM pamätí. Vo výskume sa ALD používa okrem iného pri príprave
tenkých vrstiev pre odporové prepínanie (resistive switching), pasiváciu a izoláciu hradla
GaAs a GaN tranzistorov a solárnych článkov, pre prípravu tenkovrstvových tranzistorov na
báze ZnO a podobne.
Ostatné publikácie:
Mikolášek, M., Fröhlich, K., Hušeková, K., Ondrejka, P., Chymo, F., Kemeny, M., Hotový, I., and Harmatha, L.: Development and characterisation of photoelectrochemical MIS structures with RuO2/TiO2 gate stacs for water oxidation, J. Electr. Engn. 72 (2021) 203–207. (VEGA 1/0529/20, 1/0789/21, APVV 17-0169).
Chymo, F., Fröhlich, K., Hušeková, K., Weis, M., and Mikolášek, M.: Characterization of MIS photoanodes with thin Pt layer for water splitting applications. In Proc. 9th Inter. Conf. on Advances in Electron. Photon. Technol. – ADEPT. Žilina: EDIS 2021. ISBN 978-80-554-1735-6. P. 207-210.
Sahoo, P.P., Mikolášek, M., Hušeková, K., Dobročka, E., Šoltýs, J., Ondrejka, P., Kemény, M., Harmatha, L., Mičušík, M., and Fröhlich, K.: Si-based metal-insulator-semiconductor structures with RuO2-(IrO2) films for photoelectrochemical water oxidation, ACS Applied Energy Mater. 4 (2021) 11162-11172. (VEGA 1/0529/20 and 2/0136/18, APVV 17−0169, ERDF 313021T081)
Kundrata, I., Mošková, A., Moško, M., Mičušík, M., Dobročka, E., and Fröhlich, K.: Atomic layer deposition of lithium metaphosphate from H3PO4 and P4O10 facilitated via direct liquid injection: Experiment and theory, J. Vacuum Sci Technol. A 39 (2021) 062407. (VEGA 2/0136/18, ERDF 313021T081).
Mošková, A., Moško, M., Precner, M., Mikolášek, M., Rosová, A., Mičušík, M., Štrbík, V., Šoltýs, J., Gucmann, F., Dobročka, E., and Fröhlich, K.: Doping efficiency and electron transport in Al-doped ZnO films grown by atomic layer deposition, J. Applied Phys. 130 (2021) 035106. (APVV 17-0169, VEGA 2/0136/18, 02/0010/18, 2/0131/19, ERDF 313021T081)
Niu, G., Calka, P., Huang, P., Sharath, S.U., Petzold, S., Gloskovskii, A., Fröhlich, K., Zhao, Y., Kang, J., Schubert, M.A., Bärwolf, F., Ren, W., Ye, Z.-G., Perez, E., Wenger, C., Alff, L., and Schroeder, T.: Operando diagnostic detection of interfacial oxygen ‘breathing’ of resistive random access memory by bulk-sensitive hard X-ray photoelectron spectroscopy, Mater. Res. Lett. 7 (2019) 117-123.
Fröhlich, K., Kundrata, I., Blaho, M., Precner, M., Ťapajna, M., Klimo, M., Šuch, O., and Škvarek, O.: Performance of HfOx– and TaOx-based resistive switching structures in circuits for min and max functions implementation, MRS Adv. 3 (2018) Iss. 59, 3427-3432.
Mikolášek, M., Fröhlich, K., Hušeková, K., Racko, J., Rehacek, V., Chymo, F., Ťapajna, M., and Harmatha, L.: Silicon based MIS photoanode for water oxidation: a comparison of RuO2 and Ni Schottky contacts, Applied Surface Sci 461 (2018) 48-53.
Fröhlich, K., Kundrata, I., Blaho, M., Precner, M., Ťapajna, M., Klimo, M., Šuch, O., and Škvarek, O.: Hafnium oxide and tantalum oxide based resistive switching structures for realization of minimum and maximum functions, J. Applied Phys. 124 (2018) 152109.
Stoklas, R., Gregušová, D., Hasenöhrl, S., Brytavskyi, I.V., Ťapajna, M., Fröhlich, , Haščík, Š., Gregor, M., and Kuzmík, J.: Characterization of interface states in AlGaN/GaN metal-oxide-semiconductor heterostructure field-effect transistors with HfO2 gate dielectric grown by atomic layer deposition, Applied Surface Sci 461 (2018) 255-259.
 Kontakt
Kontakt Intranet
Intranet EN
EN

